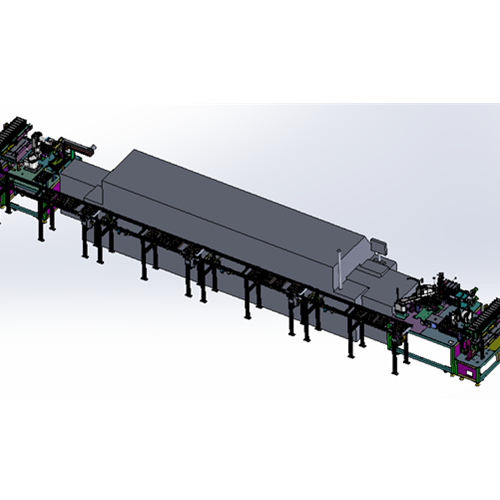
一、方案概述:
设备主要完成半导体封装DIP24/27、SOP27/DFN3、DFN5等等器件。焊线底座、瓷基板、引线框架、磁性钢片等通过机器人封装在一块送入回流炉,元器件封装固定后,用CCD检测封装效果,六轴机器人撕开磁性钢片后,放于堆叠料堆中,将焊线底座吸入传送带,传送至回流焊炉前方。
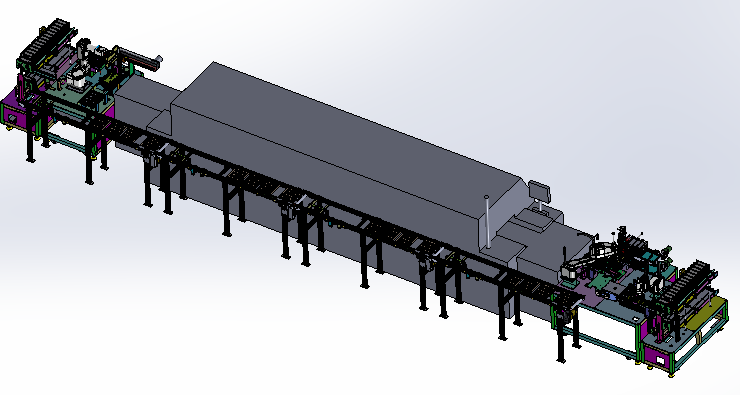
二、方案优势:
| 效率快,效率:42S/板;完美匹配回流焊节拍,充分利用设备。精度高,利用机器人和视觉定位,精度可达+-0.03mm。自动识别产品类型,自动调整相关产品参数。安全性高,有安全防护门。 |
 如果您对此感兴趣,欢迎问问展商吧!
如果您对此感兴趣,欢迎问问展商吧!
 如果您对此感兴趣,欢迎问问展商吧!
如果您对此感兴趣,欢迎问问展商吧!